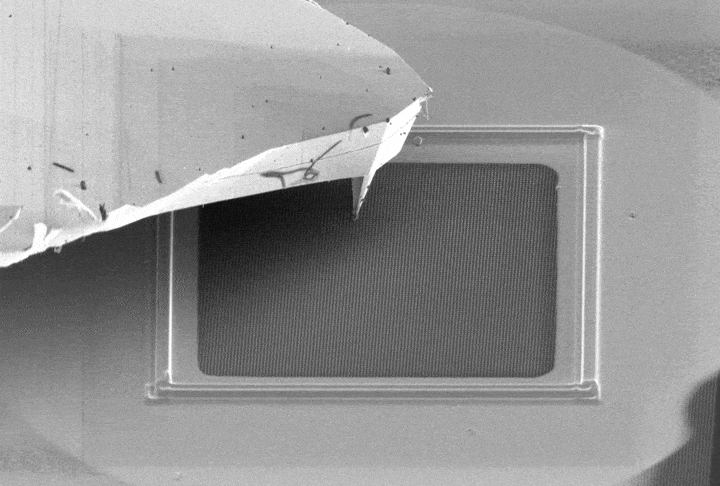
Semiconductor Failure Analysis
In-situ, site-specific, electrical and topographical characterization of semiconductor components at the nanoscale.
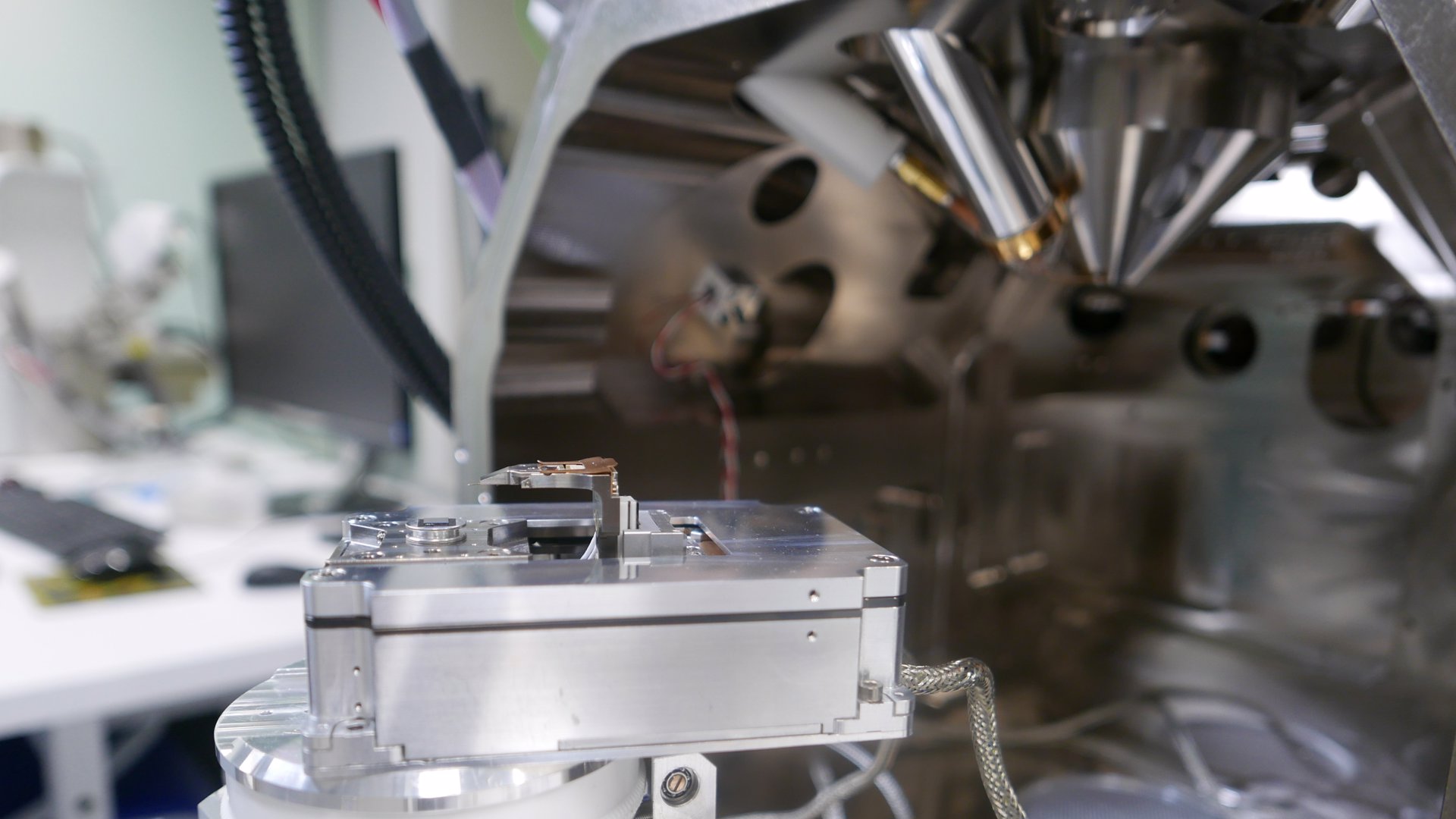
LiteScope AFM-in-SEM
Merge the power of AFM and SEM in a single tool to explore the secrets of nanoworld.
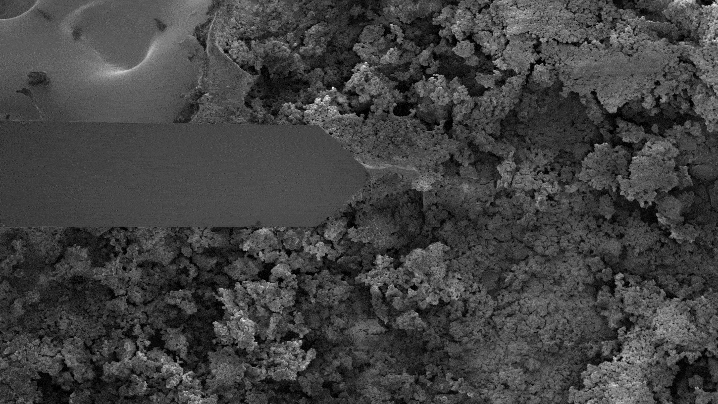
Battery Component Materials Analyses
Introducing our Battery Component Materials research solution.

LiteScope 2.5
This award-winning tool within the field of In-Situ Correlative Microscopy has the potential to revolutionize the way you perform correlative analysis.
- In-situ multimodal & correlative analysis
- Optimized & time-efficient workflow
- Ultimate performance inside SEM
- Open-hardware design for easy customization
The new generation of LiteScope AFM-in-SEM is built on the completely new state-of-the-art control unit NenoBox leveraging the performance and capabilities of the AFM-in-SEM to the new level.
Check our introduction video by our CEO Jan Neuman below. Do you want to know more details? Then click the contact us button!
Benefits of AFM-in-SEM solution
Combining the strengths of Atomic force microscope and Scanning electron microscope opens a wide range of possibilities. Thanks to seamless integration and one click operations is possible to correlate various measurements in real time.
See the unique benefits of the AFM-in-SEM solution, which assure you measurement results impossible to reach by separate AFM and SEM techniques. Check the biggest advantages of in-situ analysis by using them simultaneously!
Cutting-edge CPEM technology allows the simultaneous acquisition of AFM and SEM data and their seamless correlation.
In-situ conditions inside the SEM ensure sample analysis at the same time, in the same place and under the same conditions.
Extremely precise and timesaving approach uses SEM to navigate the AFM tip to the region of interest, enabling its fast & easy localization.
Merge the forces of AFM and SEM
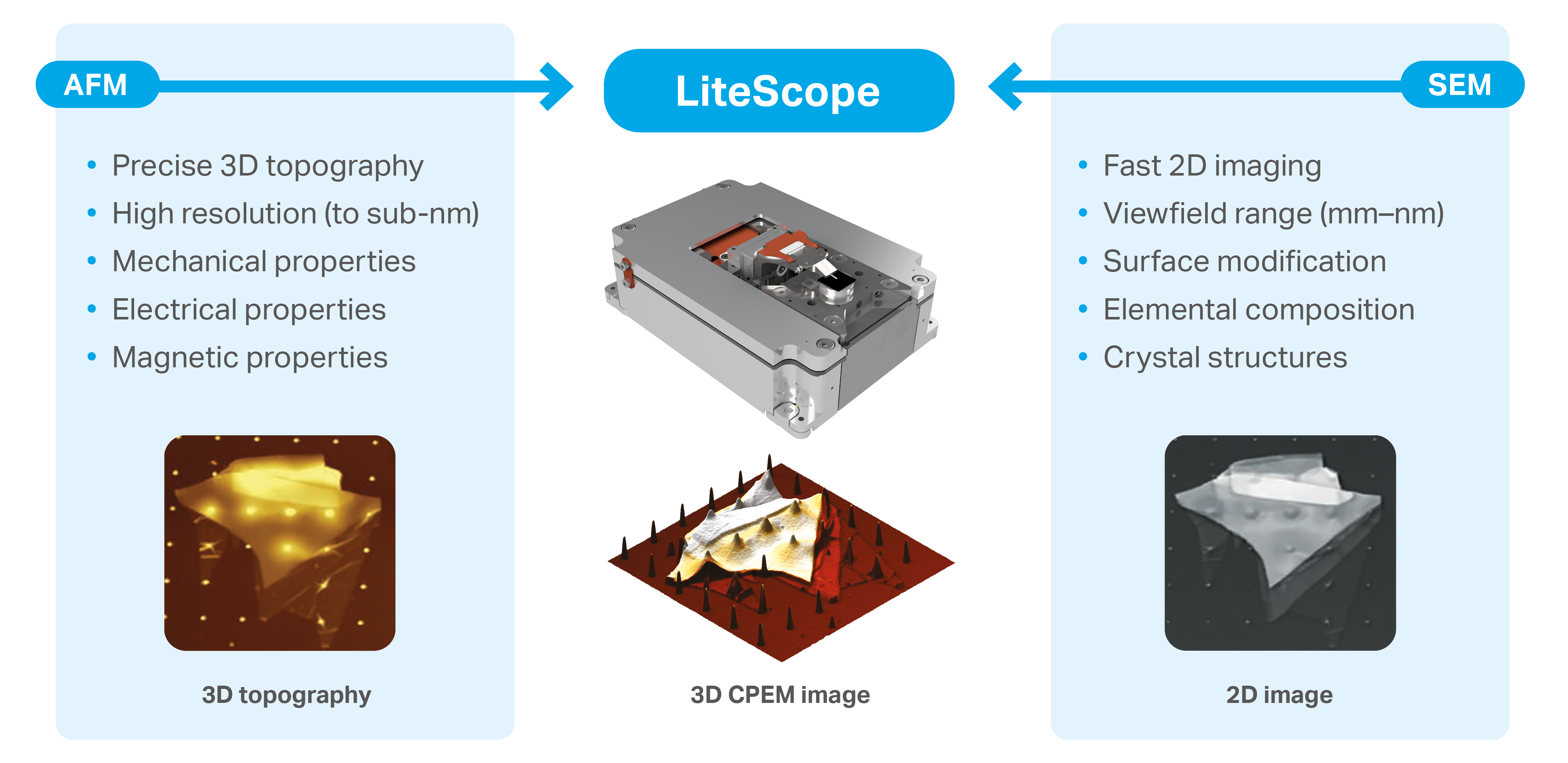
Applications
AFM-in-SEM offers a broad field of sample analysis. Simultaneous utilization of Scanning electron microscope and Atomic force microscope is indispensable for advanced 3D correlative analysis while reducing overal image acquisition time.
The easy & efficient workflow assures fast and quality measurement results. With the ultra-high resolution and unparalleled accuracy of image alignment, the versatility of LiteScope brings the new possibilities into variety of application areas:
Products
We develop and produce AFM-in-SEM LiteScope, used for correlative and multimodal in-situ analysis of microscopic samples.
Learn about our unique AFM-in-SEM solution and its capabilites & modalities that can change the way you characterize the samples.

Unique technology for correlative imaging
The Correlative Probe & Electron Microscopy (CPEM) is a cutting-edge technology developed specially for seamless integration of AFM and SEM.

Do you want to learn more? Feel free to...
Latest News

From Brno to Taiwan: LiteScope Meets the Heart of the Semiconductor World

LiteScope Open Demo Days in Brno — Book Your Slot for May 11–15, 2026

NenoVision has won the Czech Head 2025 award!


