Failure analysis of a Bipolar Junction Transistor (BJT)
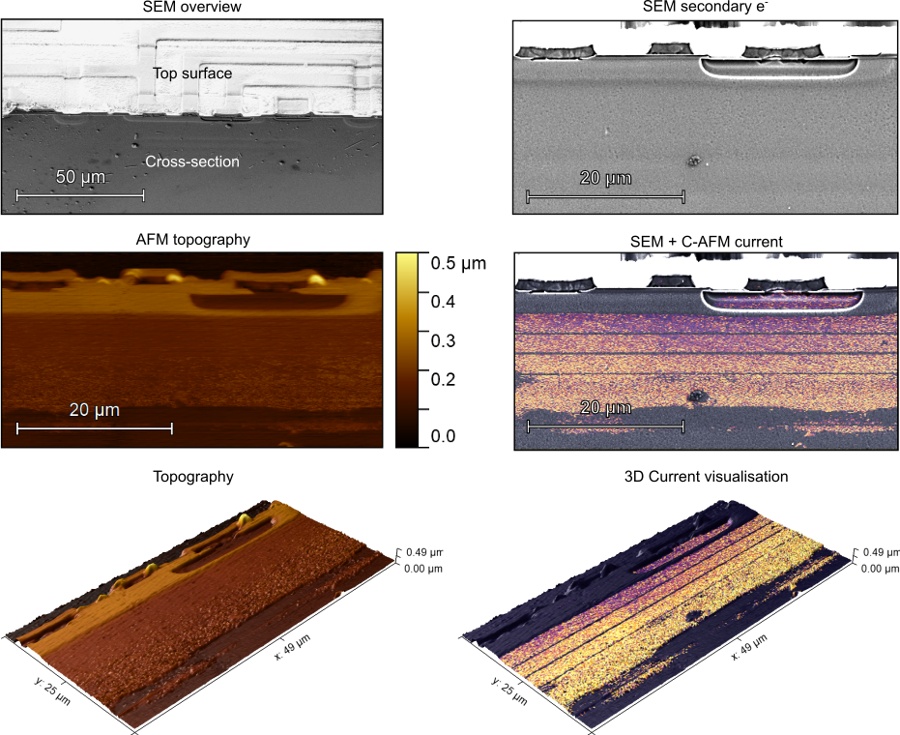
The failure analysis of the cross-section of Bipolar Junction Transistor (BJT) was studied after FIB etching.
Using the LiteScope implemented into the SEM we could easily identify the area of interest using SEM and provide AFM topography study including conductivity mapping under the in-situ conditions with use of the C-AFM technique.
Measurement modes: C-AFM, Topography
LiteScope benefits:
- FIB etching as an alternative to chemical etching for SEM contrast
- Fast and easy ROI identification using SEM
- Conductivity mapping under in-situ conditions, C-AFM is independent of SEM material contrast
Sample courtesy of David Pléha, ON Semiconductor
See also

Want to discuss your own application?
