Failure analysis of a NAND structure
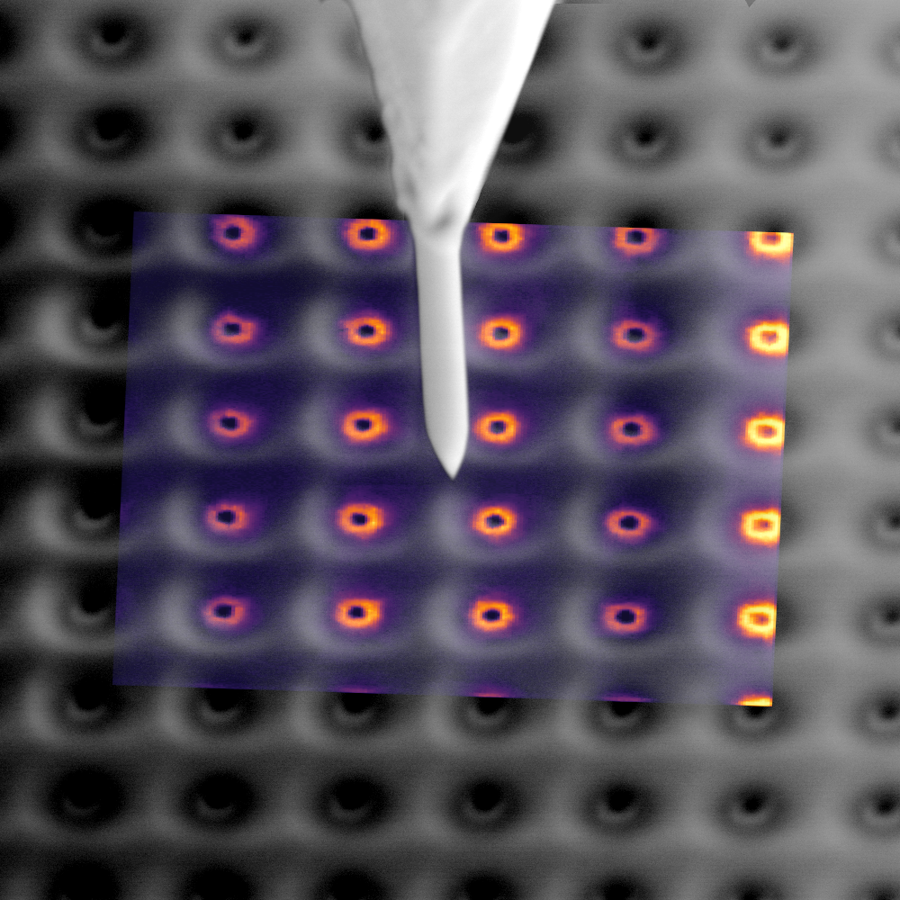
Using AFM-in-FIB/SEM, specific vias in a NAND structure were identified, sequentionally delayered using PFIB and analyzed via Conductive-AFM mapping (C-AFM) and I/V spectroscopy.
This approach provides real-time monitoring of the delayering process, ensuring accurate via targeting and revealing electrical failures of the nodes at different depths.
Failure analysis with AFM-in-FIB/SEM begins with site-specific sample preparation using FIB to expose to the defect area. The AFM tip is then navigated to the region of interest for high-resolution electrical characterization, such as C-AFM or SSRM. Results are correlated (calibrated if needed) with SEM techniques for a comprehensive failure understanding.
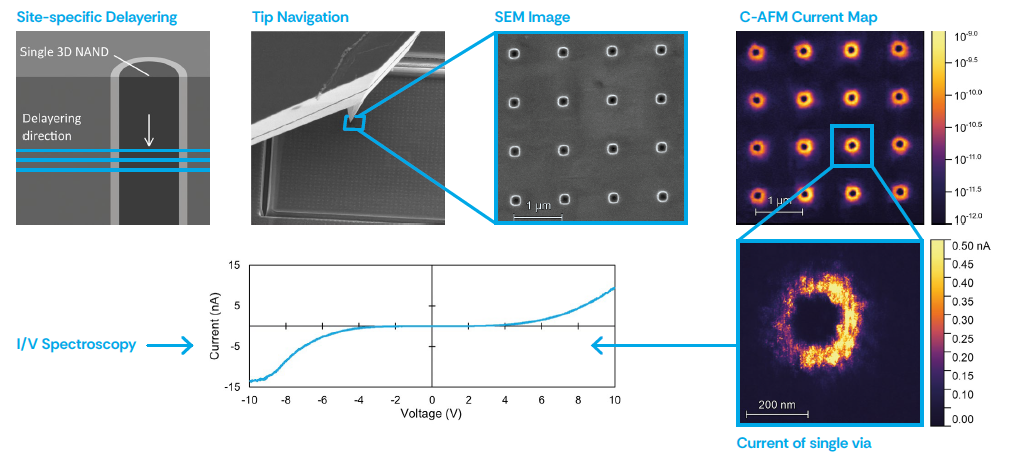
See also




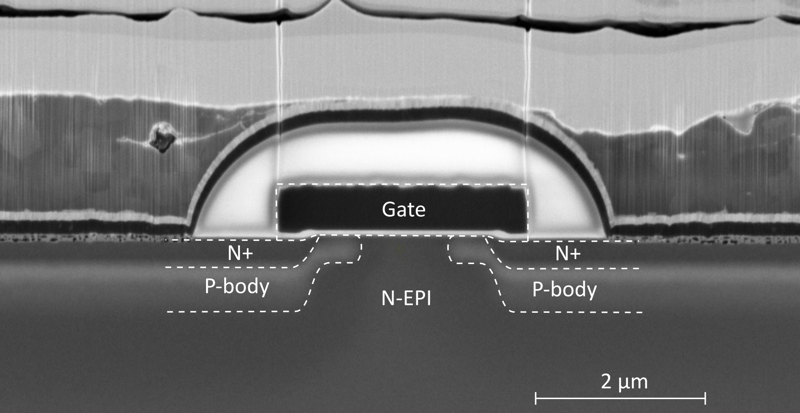

Want to discuss your own application?
